 您当前的位置:
您当前的位置: TOF-SIMS介绍
————————————————————————————————————————————————————
飞行时间-二次离子质谱仪(TOF-SIMS)是一种基于质谱的表面分析技术。高能一次离子束(如Ga+,Bi3+, Arn+,Cs+等)轰击样品表面,在轰击区域产生包含样品表面成分信息的带电离子(碎片),这些带电离子经过质量分析后得到样品表面信息。TOF-SIMS因其高灵敏度和高质量分辨率等特性,广泛应用于半导体行业的掺杂与杂质的分析,电子行业的痕量污染物分析,生物制药行业等。 高能一次离子轰击样品表面产生的二次离子被提取到无场漂移管,沿既定飞行路径到达检测器。由于给定离子的速度与其质量成反比,因此不同质量的 离子的飞行时间不同。质量越轻,到达检测器的时间越早。通过监测进入检测器的离子的飞行时间可以得到样品表面的质谱。 |
|
TOF-SIMS仪器介绍
————————————————————————————————————————————————————
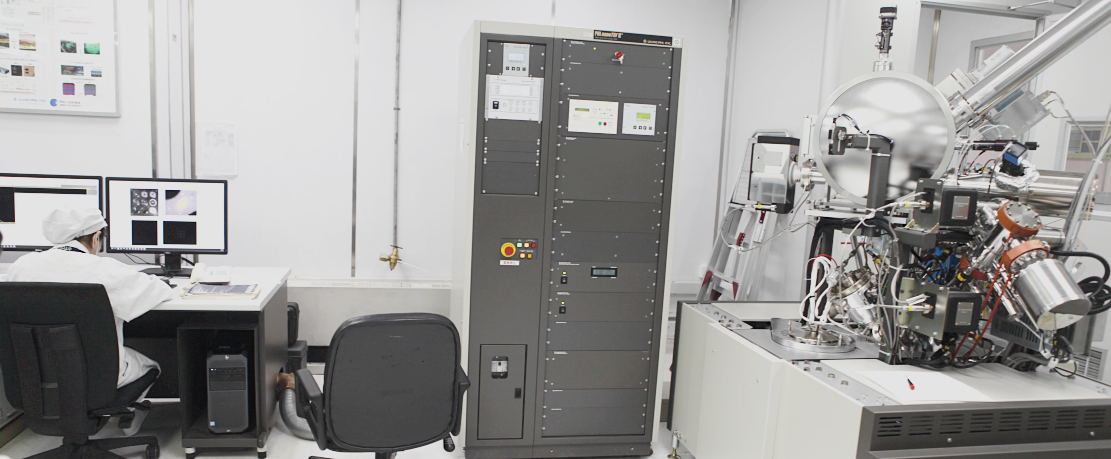
|
仪器能力
获得的信息:元素(H~U), 同位素、 分子结构、 化学键接 采集深度:1-10Å 空间分辨率:0.07 µm 成分检出限:~1ppm 深度剖析功能:具备 定量能力:需要标准品
|
TOF-SIMS应用范围
————————————————————————————————————————————————————
同位素分析
轻元素分析
痕量物质的分析(ppb-ppm)
表面超薄有机污染物分析
深度剖析:超薄多层薄膜结构分析(膜层厚度nm),特别是有机薄膜。
表面有机涂层分析(纳米级)
原位分析
TOF-SIMS应用实例
————————————————————————————————————————————————————

3D应用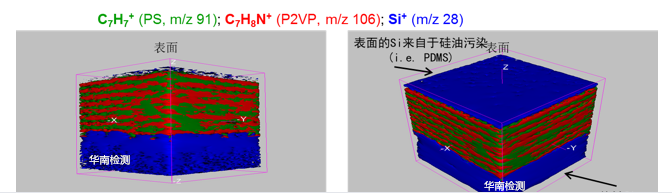
TOF-SIMS来样要求
————————————————————————————————————————————————————
磁性材料不可分析
样品导电性:无论是导体, 半导体还是绝缘样品,都可以分析
样品形态:可对固体、液体样品进行分析,但不能对其中的挥发性成分进行分析
样品尺寸:常规样品:长/宽<1cm,厚度<1cm;特殊样品:长/宽<9cm,厚度<1cm
样品包装注意事项:样品用干净材料包装,尽量避免接触测试面,存放于温湿度适宜条件下,有条件最好真空包装
样品制备注意事项:需测试样品表面成分的,请不要对样品进行擦拭、触摸等,避免污染测试面;
测试本体成分的,可以对样品进行破开,露出新鲜断面
使用导电胶进行样品制备时,要及时进行分析