引言
当您设计的无线网卡突然出现“识别不到设备”或“不显示WiFi”的故障时,问题可能并非出在芯片本身,而在于其与电路板的连接——BGA焊点。本文将通过一个真实的无线网卡失效案例,为您详细解读芯片失效分析的完整流程。我们将从红墨水试验、金相切片到SEM/EDS分析,层层深入,揭示导致BGA焊点开裂的“元凶”——柯肯达尔孔洞。通过本文,您将了解到专业的芯片失效分析如何精准定位问题根源,为产品可靠性提供有力保障。

近期,我们接收到4片出现故障的无线网卡。其中,2片表现为无法识别设备,另外2片则是不显示WiFi信号。初步怀疑是BGA芯片的焊接出现了问题。为了验证这一猜想,并找到失效的根本原因,我们启动了一次全面的芯片失效分析。本次分析的核心目标,就是确定焊点是否存在缺陷,以及这些缺陷是如何导致产品功能失效的。

在芯片失效分析中,红墨水试验是快速检测焊点是否开裂的有效手段。我们选择了两片故障样品(1#和3#)进行此项测试。
试验过程:将样品浸泡在红色染料中,利用毛细作用,让染料渗入任何存在的缝隙中。随后,将BGA芯片与PCB板分离,观察染色情况。
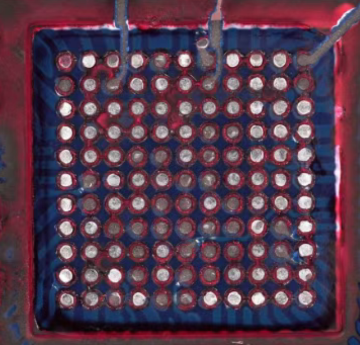
结果分析:结果显示,1#和3#样品的BGA与基板之间均存在明显的缝隙。通过对比红墨水评判标准,我们可以清晰地看到,这些缝隙的位置和程度,直接对应了失效焊点。这初步证实了我们的猜想:BGA焊点存在开裂,是导致产品功能异常的直接原因。
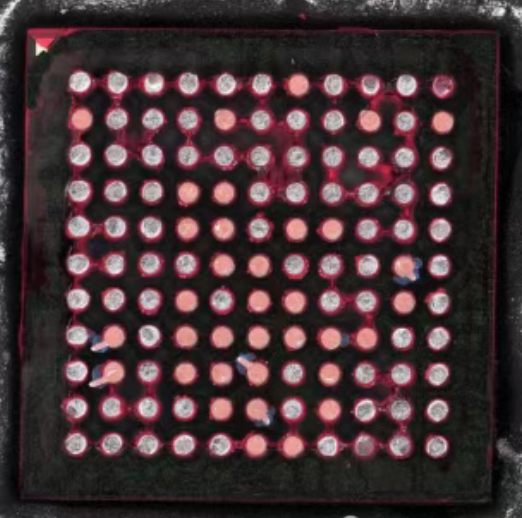
1# BGA断面形貌

3#PBGA断面形貌
红墨水试验找到了裂纹,但我们需要更深入地了解焊点的内部结构。接下来,我们对2#和4#样品进行了金相切片分析。这是芯片失效分析中观察焊点微观结构的核心步骤。
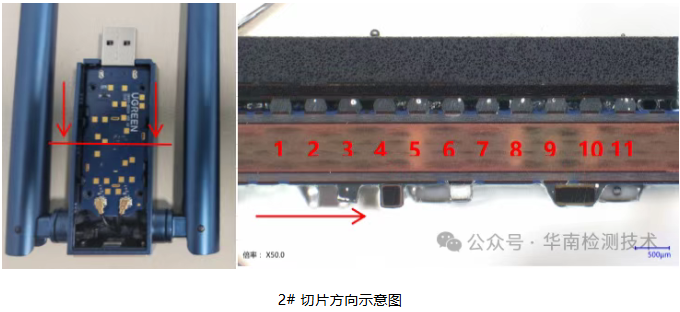
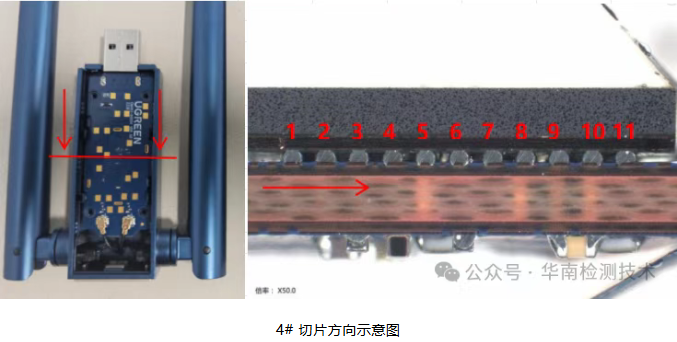
焊接初始状态良好:在显微镜下观察切片后的焊点,我们发现所有焊点均已形成了良好的金属间化合物层(IMC)。这有力证明了这些焊点在初始焊接时质量是合格的。
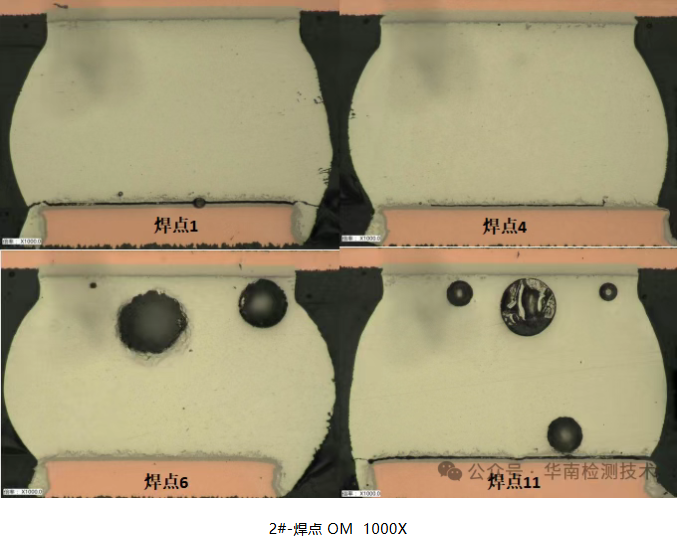
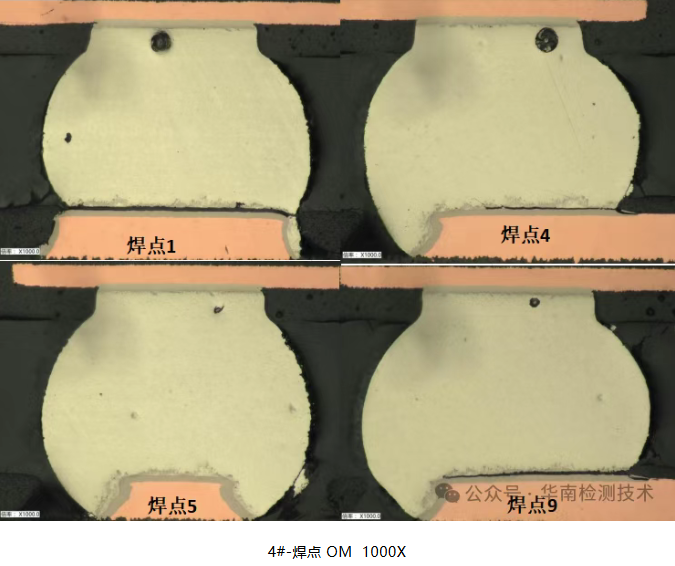
裂纹在使用中产生:然而,部分焊点中出现了不同程度的裂纹。裂纹的存在,结合IMC层的完好,说明焊点是在后续的使用过程中,受到应力或环境因素的影响才开始开裂的。这为我们揭示了失效的时间点。
金相切片让我们看到了裂纹,但究竟是什么原因导致了裂纹的产生?这需要更高级的分析工具。我们使用扫描电子显微镜(SEM)和能谱分析(EDS)对2#和4#样品进行了深入检测,这是芯片失效分析中确定失效机理的关键环节。
SEM图像清晰地显示,在焊点的镍层与焊锡之间,形成了一个三层结构。靠近焊锡的一层是 (Ni,Cu)3Sn4,中间是Ni-Sn-P层,靠近镍层的是Ni3P。最关键的问题出现在中间层——Ni-Sn-P层中,我们发现了大量微小的空洞,即“柯肯达尔孔洞”。
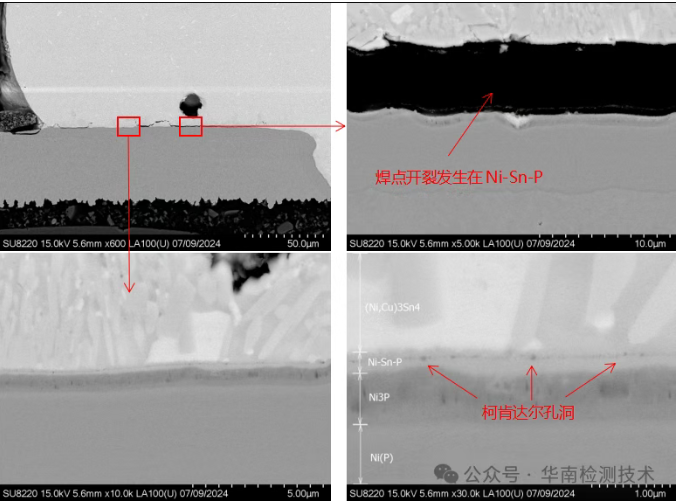
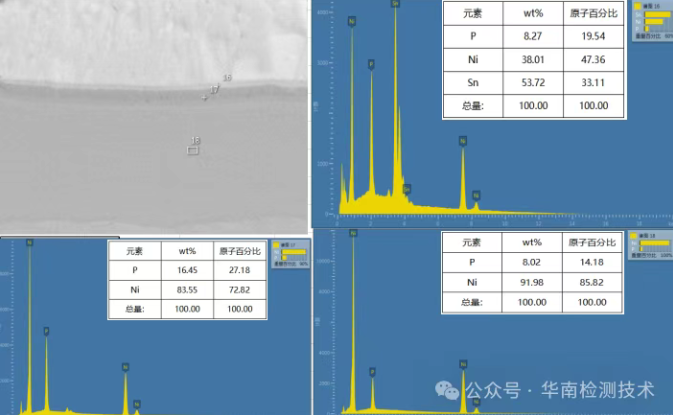
4#样品的严重状态:在4#样品中,这些微小的柯肯达尔孔洞已经连接成了一条条连续的裂缝,严重破坏了焊点的结构强度。
断裂模式的确认:我们进一步对3#样品中断裂严重(E5)和未开裂(A5)的焊点断口进行了分析。结果显示,所有断口均为脆性断裂,未见塑性变形。A5焊点的断裂发生在焊锡与IMC层的界面,而E5焊点的断裂则直接发生在Ni-Sn-P IMC层,印证了该层是焊点最薄弱的环节。
为什么会在Ni-Sn-P层形成柯肯达尔孔洞?这源于原子扩散速率的不平衡。简单来说,锡原子从(Ni,Cu)3Sn4层向外扩散的速度,远快于从外部向Ni-Sn-P层内部扩散的速度。Ni3P层提供了更高效的原子扩散通道,加速了锡原子的流失,导致在Ni-Sn-P层中留下大量空位,最终聚集形成孔洞。
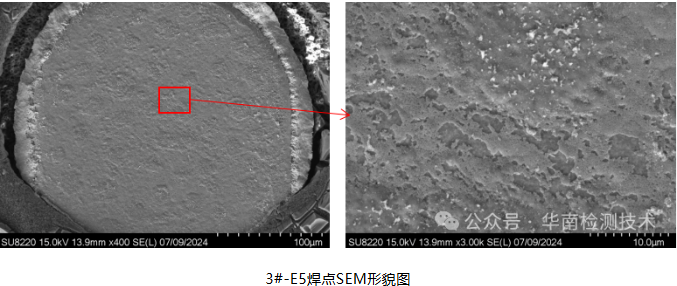
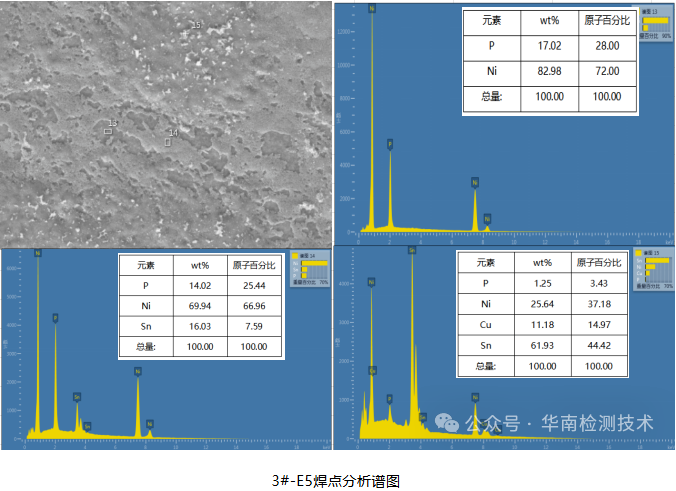
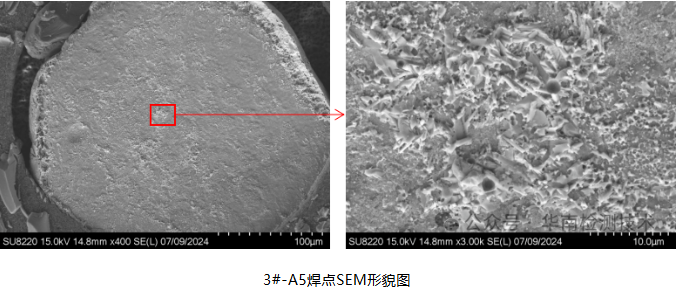

通过以上四步严谨的芯片失效分析流程,我们最终得出了清晰的结论:
直接原因:焊点内部的Ni-Sn-P IMC层中,产生了大量柯肯达尔孔洞。
失效过程:这些孔洞严重削弱了焊点的机械强度。在产品服役过程中,受到热循环或机械应力的作用,焊点在Ni-Sn-P层薄弱处发生开裂。
最终表现:开裂的焊点导致电气连接中断,从而引发无线网卡“识别不到设备”或“不显示WiFi”的功能性故障。
这个案例充分说明,一个看似简单的功能失效,背后可能隐藏着复杂的材料学和物理学原理。专业的芯片失效分析,正是解开这些谜题的关键。

当您的电子产品遇到类似的可靠性问题时,选择一家专业的第三方检测机构至关重要。广东省华南检测技术有限公司,专注于电子元器件的失效分析与可靠性检测。我们拥有一支经验丰富的技术团队和业界高端的测试设备,包括金相显微镜、扫描电镜(SEM)、能谱仪(EDS)以及各类可靠性试验设备,能够为您提供从快速定位到深层机理分析的一站式服务。

电子元器件失效分析
集成电路失效分析
金属材料失效分析
高分子材料失效分析
我们致力于通过专业的检测和客观的数据,帮助客户从根本上解决质量问题,提升产品的可靠性和市场竞争力。

如果您正面临芯片失效的困扰,或希望了解更多关于芯片失效分析的细节,欢迎联系我们广东省华南检测技术有限公司,获取定制化的解决方案。